For encapsulation of wirebonded IC’s
Zymet's glob top and dam-and-fill encapsulants are UV curable, yet they have properties similar to conventional heat cured encapsulants, high Tg’s and low CTE’s. With UV cure, curing is performed quickly, inline, at low te...
|
Materials |
For bonding of stress sensitive devices
In microelectronics assembly, adhesives are most often used to bond dissimilar materials with mismatched coefficients of thermal expansion. As a consequence, the bonded parts bend at temperatures above and below the adhesive curing temperatu...
|
Materials |
Zymet's optoelectronics adhesives are designed for applications such as fiber assembly, connector or ferrule assembly, VCSEL assembly, Bragg Grating assembly, and many others.
The adhesives offer the following features:
One component, syringe dispensable syst...
|
Materials |
For flip chip attachment of RFID and smartcard IC’s
Zymet's NCP’s are designed for flip chip attachment of gold bumped IC’s. Although they are specifically designed for RFID and smartcard assembly they can also be used for other flip chip applications. To fac...
|
Materials |
For heat dissipation
Conventional methods measure an adhesive's bulk conductivity, in watts/m-°K. However, across a thin bondline, the resistance of the adhesive itself is only a fraction of the total resistance. Interfacial resistance is a significant compo...
|
Materials |
For die attach and general electronics assembly
Die Attach Adhesives
Zymet's electrically conductive die attach adhesives for semiconductor package assembly, hybrid IC assembly, COB IC assembly, and smartcard IC assembly. The adhesives are syringe dispensable past...
|
Materials |
For flip chip attachment or electrical grounding
ACP's for Electrical Interconnection
Zymet's ACP’s designed for electrical interconnection are used for flip chip attachment. Applications include chip-on-glass (COG) attachment of driver IC's and chip...
|
Materials |
Zymet's underfill encapsulants for flip chips are designed to enhance the thermal cycle performance. They incorporate silica filler, used to reduce the encapsulant’s CTE, that are highly engineered in both morphology and particle size distribution to achieve the fast, void free encap...
|
Materials |





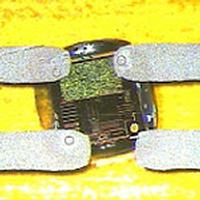


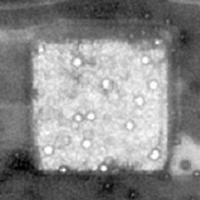







.gif)